삼성전자, 하이브리드 본딩 적용 HBM '2년 뒤' 양산 최근 학회서 로드맵 공개, 16단 HBM4부터 적용 가능성
노태민 기자공개 2024-10-16 07:47:49
이 기사는 2024년 10월 15일 14:41 thebell 에 표출된 기사입니다.
삼성전자가 2026년 고대역폭메모리(HBM)4를 양산할 때 하이브리드 본딩 공정을 적용하겠다는 로드맵을 내놨다. 16단 이상 HBM에 하이브리드 본딩 적용을 시사한 적은 있지만 공정 도입 시기를 언급한 건 이번이 처음이다. HBM4에는 하이브리드 본딩 외에도 10나노급 6세대 D램(D1c), 4nm 로직 다이 등을 도입한다.15일 업계에 따르면 삼성전자는 최근 한 학회에서 하이브리드 본딩 공정 로드맵을 공개했다. 로드맵을 살펴보면 HBM4부터 하이브리드 본딩 기술을 도입한다는 계획이다. 양산 목표 시점은 2026년으로 표기돼 있다. 기술 도입 시점과 삼성전자의 HBM4 양산 일정 등을 고려하면 16단 제품부터 하이브리드 본딩 기술이 적용될 확률이 높다.
하이브리드 본딩은 두 개 이상의 칩을 연결하기 위한 패키지 기술이다. 현재 HBM 양산에는 열압착(TC) 본딩 기술이 쓰이고 있으나 발열, 폼팩터 등 이슈를 해결하기 위해 하이브리드 본딩 사용이 논의되고 있다. 두 기술의 가장 큰 차이점은 하이브리드 본딩의 경우 갭리스 공정이란 점이다.
TC 본딩은 비전도성접착필름(NCF)을 통해 칩을 부착했다면 하이브리드 본딩은 칩의 유전체(SiO2, SiCN 등)와 구리(Cu)를 각각 부착해 칩을 연결한다. 하이브리드 본딩을 통해 갭을 줄이면 80um 이상의 여유 공간 확보도 기대할 수 있다.
현재 HBM3E와 HBM4 등 제품의 코어다이 간 간격은 7um 수준이다. 16단 제품의 경우 775um의 제한된 폼팩터에 코어 다이 16개를 적층해야 하는 만큼 이전 세대 제품보다 칩 간 갭을 줄이는 것이 더욱 중요해졌다.
삼성전자 고위 관계자는 "하이브리드 본딩을 도입하면 HBM의 발열 이슈를 개선할 수 있다"며 "또, 갭을 없애는 만큼 코어 다이 두께에도 여유가 생긴다"고 말했다.
삼성전자는 지난해 ECTC에서 HBM에 하이브리드 본딩 공정 적용 시 TC 본딩과 비교해 패키지 열 저항을 최대 20% 가까이 줄일 수 있다고 발표한 바 있다.
반도체 장비 업계 관계자는 "삼성전자가 16단 HBM 개발을 투트랙으로 가고 있는데, TC 본딩 방식의 경우 제품 개발에 어려움을 겪고 있는 것으로 알고 있다"며 "삼성전자가 16단 HBM 양산을 위해 하이브리드 본딩 공정을 채택할 확률이 높다"고 전했다.
삼성전자가 하이브리드 본딩 공정 도입을 앞두고 있는 만큼 HBM 관련 밸류체인도 크게 바뀔 것으로 예상된다. 국내 장비 업계에서는 삼성전자가 베시와 어플라이드머티어리얼즈(어플라이드)의 하이브리드 본딩 관련 장비를 대량 구입할 것으로 보고 있다. 이외에도 NCF 필름 사용량도 줄어들 것으로 보인다.
경쟁사인 SK하이닉스는 16단 HBM에도 기존 적층 기술인 어드밴스드 매스리플로우(MR)-몰디드언더필(MUF)을 적용하는 것으로 알려졌다. 다만 20단 이상 HBM 양산을 대비해 하이브리드 본딩 연구는 진행 중이다.
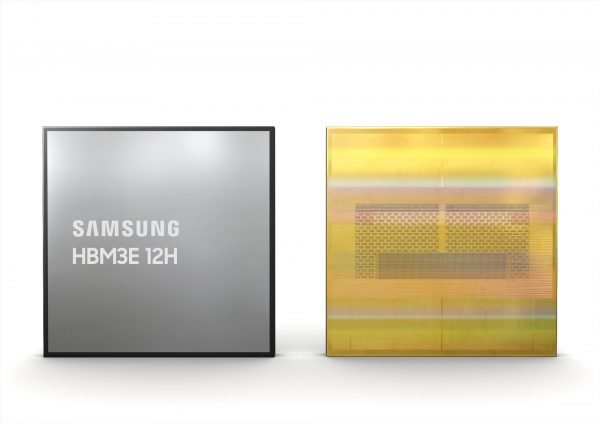
< 저작권자 ⓒ 자본시장 미디어 'thebell', 무단 전재, 재배포 및 AI학습 이용 금지 >
best clicks
최신뉴스 in 인더스트리
-
- [i-point]엔젤로보틱스, 조남민 단독 대표 선임
- [i-point]국떡, 광희 '할인전' 네이버 스토어 프로모션
- 동아 '이뮬도사' 상업화 선순환, '에스티젠' 흑자 기대감
- [클라우드 키플레이어 MSP 점검]SK C&C, 클라우드·DX 결합으로 실적 확대 노린다
- [Red & Blue]반등 나선 한빛레이저, LG엔솔 '포드 잭팟' 수혜 기대감
- [무신사 점프업 스토리]창업주 '조만호' 경영 복귀, 조직 정비해 '리스크 관리'
- 새출발하는 두산모트롤, 사업 결합 '키맨' 권영민 사장
- 영풍 지분 빼는 '최씨 일가' 영풍정밀 재원 가능성
- LG엔솔 잇따른 수주 낭보, 목표 달성 '청신호'
- [파고 넘는 SK온]성장성 기대감일까...삼성SDI 뛰어넘은 밸류





























